ラマン分光法 アプリケーション集
半導体材料 SiC のキャリア濃度(キャリア密度)評価
はじめに
キャリア濃度(キャリア密度)などの電気的な特性の評価には通常、電極を形成しての Hall測定が用いられますが、ラマン分光法では、ピーク位置情報から非破壊非接触でキャリア濃度の算出ができます。8インチウェーハ対応の大型自動ステージを用いることで、サンプルを切り出すなどの加工をせずに測定することができます(Fig.1)。ここではラマン分光法を用いた SiC の評価例を紹介します。
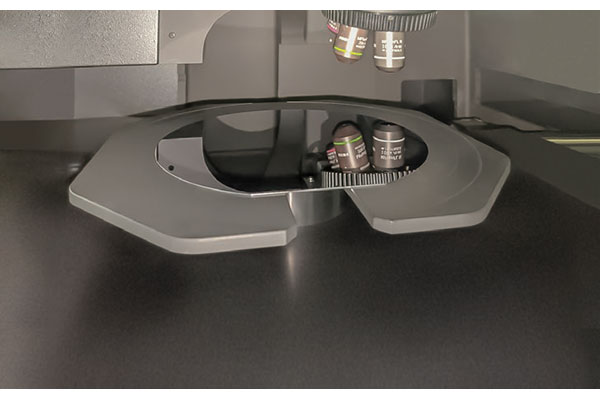
Fig.1 4/6/8インチ対応ホルダー
キャリア濃度(キャリア密度)の評価
半導体材料の特長として、不純物をドープすることで、キャリアである正孔(ホール)や自由電子の濃度を制御します。ラマン分光法では、自由電子が電荷移動の担い手である n 型の化合物半導体に対し、ピーク位置の変化からキャリア濃度の見積もりを行うことができます。
GaN、GaAs、SiC の様な極性を持つ化合物半導体では、結晶の格子振動である縦波と横波が分裂してラマンスペクトルに観測されます。n 型半導体中の自由電子キャリアが集団的に振動する波はプラズモンと呼ばれる音波と類似した粗密波(縦波)であり、格子振動の中の同じ縦波である LO(縦型光学)フォノンと相互作用したバンド(L+ と L-)が観測されます。キャリア濃度の増大とともにこのモードは高波数側にシフトしながらブロードになっていくことが知られており、ピーク位置から絶対的なキャリア濃度の評価が行われています。
今回昇華法により成長条件を変えて結晶成長させた厚み 0.33 mm の 4H-SiC 単結晶3種類を試料に用い、それぞれの試料で任意の一点を ×20 対物レンズを使って後方散乱配置でのラマン測定を行いました(532 nm 励起)。
キャリア濃度が高いほど縦波のピークが高波数側にシフトしながらブロードになっていく様子を観測できました(Fig.2)。
サンプルは東海大学 工学部 電気電子工学科(当時)犬島喬先生、太田優一様にご提供いただきました。
GaN、GaAs、SiC の様な極性を持つ化合物半導体では、結晶の格子振動である縦波と横波が分裂してラマンスペクトルに観測されます。n 型半導体中の自由電子キャリアが集団的に振動する波はプラズモンと呼ばれる音波と類似した粗密波(縦波)であり、格子振動の中の同じ縦波である LO(縦型光学)フォノンと相互作用したバンド(L+ と L-)が観測されます。キャリア濃度の増大とともにこのモードは高波数側にシフトしながらブロードになっていくことが知られており、ピーク位置から絶対的なキャリア濃度の評価が行われています。
今回昇華法により成長条件を変えて結晶成長させた厚み 0.33 mm の 4H-SiC 単結晶3種類を試料に用い、それぞれの試料で任意の一点を ×20 対物レンズを使って後方散乱配置でのラマン測定を行いました(532 nm 励起)。
キャリア濃度が高いほど縦波のピークが高波数側にシフトしながらブロードになっていく様子を観測できました(Fig.2)。
サンプルは東海大学 工学部 電気電子工学科(当時)犬島喬先生、太田優一様にご提供いただきました。
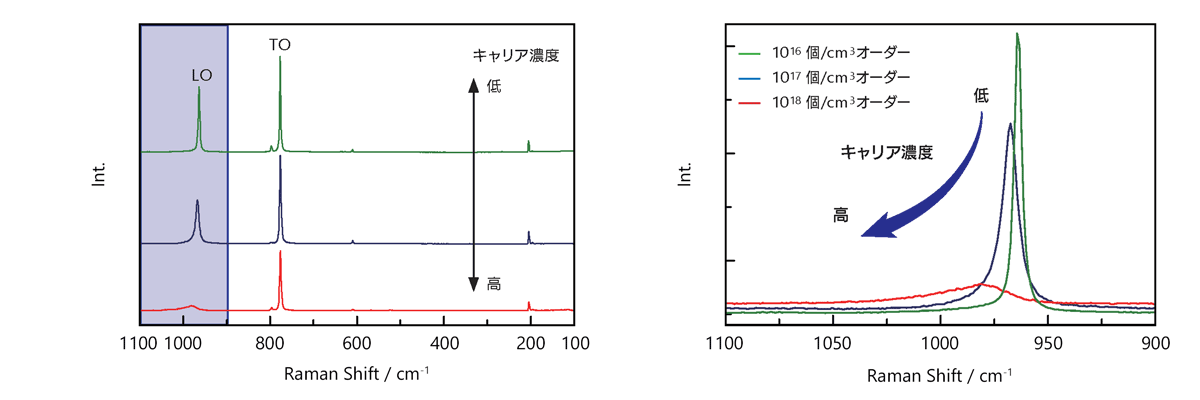
Fig.2 キャリア濃度による 4H-SiC のラマンスペクトルの変化
4H-SiC エピ膜のキャリア濃度分布の評価 - 非破壊深さ方向測定 -
ラマン分光法は非破壊での深さ方向分析を得意としているため、表面だけでなく深さ方向の情報を得ることができます。
ウェーハの表面にフォーカスを合わせた位置から 0.5 µm 間隔で計 30 点、ステージを上げながら深さ方向測定をしました(Fig.3)。深さ方向での 4H-SiC の LO ピーク(950 ~ 1000 cm-1)の変化から、表面では低キャリア濃度、内部では高キャリア濃度の層があることが分かりました。また日本分光独自の共焦点光学系である DSF(Dual Spatial Filtration)システムを使用することにより、低キャリア層、高キャリア層を明確に見分けることができました。ステージを上げた距離に SiC の屈折率を掛けた値が、実際に見ている深さ位置であると考えられます。
ウェーハの表面にフォーカスを合わせた位置から 0.5 µm 間隔で計 30 点、ステージを上げながら深さ方向測定をしました(Fig.3)。深さ方向での 4H-SiC の LO ピーク(950 ~ 1000 cm-1)の変化から、表面では低キャリア濃度、内部では高キャリア濃度の層があることが分かりました。また日本分光独自の共焦点光学系である DSF(Dual Spatial Filtration)システムを使用することにより、低キャリア層、高キャリア層を明確に見分けることができました。ステージを上げた距離に SiC の屈折率を掛けた値が、実際に見ている深さ位置であると考えられます。
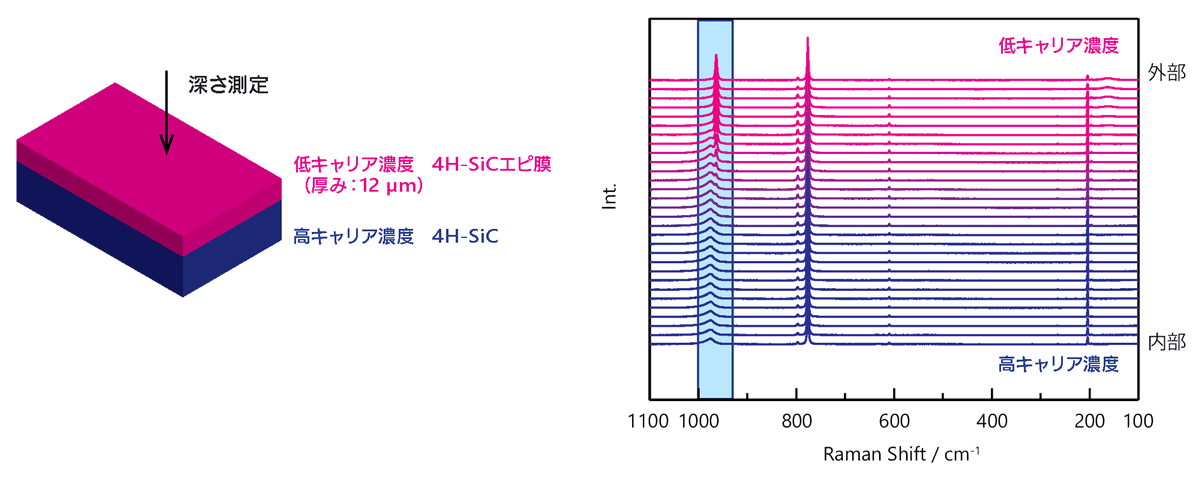
Fig.3 4H-SiC ウェーハの非破壊深さ方向測定





