トピックス
太陽電池関連分析技術(3) 膜厚測定
はじめに
薄膜や多層膜は、電池材料や光学素材、包装材など、我々の身の回りの製品に多く取り入れられています。そして、これら製品の性能や品質を管理する上で、膜厚測定は重要な役割を果たしています。今回は、太陽電池関連分析技術の第3弾として、「太陽電池の成膜過程をin-situでモニターしたい」という要望にお応えした例を紹介します。
分光干渉膜厚法に多層膜解析を用いた膜厚測定
太陽電池の成膜プロセスはテストプラントでも一部屋分位ある大きなものでした。しかし、モニターを組み込むスペースは意外に小さく、普通の分光器を組み込むことも困難なほどでした。
成膜プロセスを光学的にモニターする手法として考えられるのは分光干渉膜厚法かエリプソメトリーですが、エリプソメーターを使おうとすると、光弾性変調器(PEM)や偏光子など偏光変調のための機能を組み込まなければならず、スペースを大きくとってしまいます。そこで分光干渉膜厚法で対応しました。
成膜プロセスを光学的にモニターする手法として考えられるのは分光干渉膜厚法かエリプソメトリーですが、エリプソメーターを使おうとすると、光弾性変調器(PEM)や偏光子など偏光変調のための機能を組み込まなければならず、スペースを大きくとってしまいます。そこで分光干渉膜厚法で対応しました。
分光干渉膜厚法はシンプルで確立された方法ですが、2つ問題があります。
第1の問題は、「屈折率が一定でないと、その分必ず誤差となってしまう」ということです。一般に屈折率は波長分散があって、一定ではないものですが、「一定でないなら、見る波長範囲を狭めて、そこで一定と見なせるようにすればよい」と信じられてきました。これは間違いで、波長範囲とは関係なく微分係数(勾配)が関係し、これがゼロでなければその分が誤差になります。
第1の問題は、「屈折率が一定でないと、その分必ず誤差となってしまう」ということです。一般に屈折率は波長分散があって、一定ではないものですが、「一定でないなら、見る波長範囲を狭めて、そこで一定と見なせるようにすればよい」と信じられてきました。これは間違いで、波長範囲とは関係なく微分係数(勾配)が関係し、これがゼロでなければその分が誤差になります。

図1 分光干渉膜厚法、波長による誤差
第2の問題は、適用が事実上単層膜に限られるということです。2層となると、基板を含めて3種の膜厚があることになり、干渉波形として3つの周期が重なります。N層ともなると、N(N+1)/2個の周期の波が重なり、これを分離することは非常に困難となります。
上記の問題により、今回のケースに分光干渉膜厚法を適用するには工夫が必要になります。エリプソメトリーには、多層構造を扱うことができる、多層膜解析という手法があります。これを分光干渉膜厚法に適用することを試みました。エリプソメトリーでは、複素屈折率を偏光のパラメータに関係づけて解析しますが、分光干渉膜厚法では複素屈折率を振幅反射率(または振幅透過率)と関係づけました。この計算は結構複雑なので、結果だけ紹介します。

図2 膜厚(d)、屈折率(n)を算出するための計算式
多層膜解析による膜厚測定
プログラムに登録されているモデル式のパラメータと膜厚に適当な初期値を与えると屈折率が算出でき、そのときの反射スペクトルが図2の式に従って計算できます。プログラムは、モデル式の計算値と測定値のズレが最小になるようにパラメータと膜厚を最適化します。図3は、ガラス(BK7)基板上にYAGを成膜した試料に適用した例です。YAG,ガラスの両方に対して、コーシーの分散式(透明体、主として可視域の近似に有効)を適用し、膜厚の初期値に1000nmを与えました。この膜厚とYAGの分散式中のパラメータを最適化させた結果、計算値と実測値が非常によく一致し、膜厚の値として1012.07nmが得られました。

図3 ガラス基板上のYAGの膜厚
また、次にシリコン基板の上にSiO2を成膜、さらにその上にTiO2を成膜したものを解析しました。TiO2にはタウクーローレンツ(アモルファス半導体に有効)の式を適用し、膜厚の初期値として60nm、SiO2にはライブラリに持っている屈折率を使いました。初期値として200nmを与えて、タウクーローレンツのパラメータと両方の膜厚を変数として最適化しました。その結果、TiO2の膜厚として61.532nmが得られました。またTiO2の屈折率も求められました。こうして求まった屈折率はライブラリに登録して、以後参照することが出来るようになっています。2層膜は、これまでの干渉膜厚計算ではとても解析できませんが、多層膜解析を用いることで可能になりました。
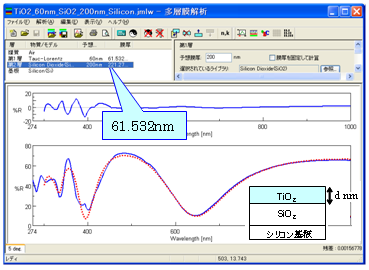
図4 シリコン基板上のSiO2/TiO2の膜厚
まとめ
今回は、太陽電池の成膜過程をin-situでモニターするために採用した、分光干渉膜厚法による多層膜解析の例を紹介しました。この方法により、エリプソメーターの設置が難しい限られたスペースでも多層膜の膜厚を測定することができました。


